阵列组态基板封装技术的技术分析
如今,业界已逐渐接受结构更为复杂的阵列组态基板封装技术,同时却也面临先天性散热、高密度等挑战。如果能克服困难,这个下一世代的封装技术可望提升众多应用元件的整体效能,并展现封装技术新契机。
据了解,在半导体电路密度增加的状况下,封装晶片在散热、机械及电子品质上,将会面临接踵而至的挑战。尽管大多数半导体元件仍继续采用引线封装结构,许多提供更复杂且更高效能产品的制造商,已经开始倾向采用阵列组态的基板封装。运用均匀阵列式接点结构,基板的中介层得以将最终封装的外围轮廓缩至最小。基板与中介层通常指的是相同的东西:一个具有提供接地与电源分配功能的电子互连介面中介层。
电路生产要求多 基板铸造与众不同
在接点的间距或间隔被缩减时,接点的密度可以超越引线封装,从而电子通道的长度得以缩短。导体的通道越短,电感就越小,而且因接点是在晶粒元件的正下方,因此可藉由基板至宿主(Host)电路结构之间的连结,进而达到更好的散热效果。上述特性使得阵列封装脱颖而出,比传统的引线封装结构更适合使用在各式各样的元件,其中包括微处理器、微控制器、特殊应用IC、记忆体和个人电脑晶片组等应用产品。
半导体封装设计的基板铸造,是电子产业中一个十分特殊的市场,其部分的原因是因为这样的技术在高电路密度、高电子效能和散热稳定性上都有一些特殊要求(图1)。另外,叠层式基板则是针对阵列封装所设计,举例来说,它可能含有一、二或数层的电路,并特别针对较高输入/输出(I/O)数量的半导体应用量身设计。
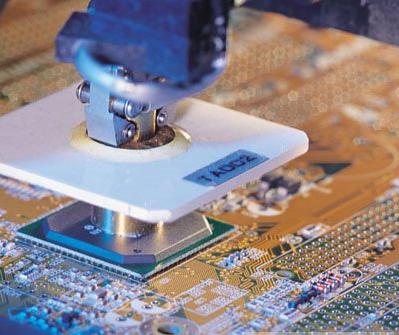
图1 当下,电路板须满足高密度、高效能和散热稳定等特性。
许多的有机基板材质,在较高的玻璃转移温度(Tg)下加工处理后,能够达到比较低的介电常数,并具有优异的绝缘特性。业界亦开发出许多材料,不仅具备更好的高频(HF)效能,而且和商业化环氧树脂/层压玻璃一样容易制造。这类材料称为强化纤维复合玻璃,内含陶瓷充填的热凝性原料,而这种特殊材料经过极高的Tg(>280℃)温度处理后,即可在高温环境下运作。
驱动先进封装技术 小尺寸/低成本需求扮要角
半导体封装所采用的基板,可和多个导线层一起进行加工处理,而整合这些导线层中的被动元件有许多方法。为了符合系统层级的效能与密度上要求,加工后的半导体封装必须具备理想的散热与电子特性,以提高晶粒的效能。
新开发的先进封装技术,亦须考量市场对于更小尺寸、更多I/O及尽可能压低封装成本方面的需求。影响基板成本的因素包括专属材料、电路层数量及绕线复杂度。在需要两层或更多电路层时,金属面或电路会藉由镀通孔(PTH)或半通导孔(Partially Formed Via)相互连结,方法和用于第二层构装的传统印刷电路板(PCB)相同。而复杂度较低的半导体在封装时,虽然只需要一或两个金属层,但具有较高I/O与高效能的半导体则需要额外电路层,以作为封装内绕线电源分配与接地的用途。
多层基板设计是主流 低成本有机材料基板受青睐
在单一晶片要求更多的功能时,每个新世代的产品就必须整合越来越多的电晶体或位元。一般而言,随着晶片内部电晶体的数量持续增加,就会需要更多的焊垫与接脚,才能让I/O讯号能够进出IC。虽然有一些半导体封装基板仅需要二或四层的增层式电路板,但一般基板的电路层数量则是持续增加。有几家基板供应商近期将针对45奈米元件采用十至十四层的基板。例如像英特尔(Intel)的65奈米Presler处理器就是用十二层基板制成,而英特尔的45奈米凌动(Atom)处理器则采用六层基板。向来采用陶瓷基板来制造高效能半导体的升阳(Sun),表示运用更多层基板的设计,可使低成本的有机材料基板,成为多款新微处理器的理想替代方案。
覆晶接合法渐取代引线搭接 高密度晶粒疑虑待解决
透过对产业的观察,材料的研发对于大多数技术演进而言,是重要的基石。而产业的里程碑也持续反映出,材料与制程的改良是促进新技术发展、改进产品效能及提高制造效率的重要助力。此外,产品研发业者也深刻地体认到,在将引线搭接晶粒到基板间介面,并无法满足所有应用中效能优化的标准,尤其是在高速处理器与特定应用积体电路(ASIC)产品日益增加的情况下。
目前,针对下个世代的元件产品,半导体供应商完全舍弃传统引线搭接的封装组合法,转而选择更具备微型化优势的晶粒面朝下的覆晶(FC)接合法。不过这其中也存在一些问题,包括可能影响到覆晶晶粒的高密度、焊锡凸块的均匀度及基板的平坦度。另外,超细间距覆晶应用的电迁移效应,也可能会导致金属间化合物的形成,长期下来会在微间距接点之间形成可导电的桥接物。而这都会对覆晶应用造成灾难性的后果,因为这类应用采用高密度的直流电,随着晶粒元素结构尺寸持续缩小,此类效应也会越来越显著。



